跟小編一起來看看近期國內外電子材料領域都有哪些最新研究進展把~
1
電子封裝材料
1、J. Appl. Polym. Sci.:具有高導熱性和阻燃性的Al2O3/h-BN/環氧基電子封裝材料
為保證集成電路和微電子元器件的長期穩定運行,環氧封裝材料需要具有高導熱性來實現高效散熱,并且在過熱的情況下還需具有出色的阻燃性。
近日,華中科技大學的研究人員通過填充聚多巴胺(PDA)改性納米Al2O3球體和微米級六方氮化硼(h-BN)片得到了一種具有高導熱性和阻燃性的環氧復合材料。PDA的改性增加了填料和環氧樹脂之間的相容性,大幅降低了材料的粘度,改善了填料在環氧樹脂中的分散性,從而提高了復合材料的導熱性。此外,PDA中酚羥基和氨基在燃燒過程中產生的NH3、H2O和N2與Al2O3和h-BN的物理阻擋效應相結合,提高了復合材料的阻燃性。實驗結果表明,填充了PDA改性的Al2O3(26.67?wt%)和h-BN(13.33?wt%)的環氧復合材料(即PDA-BNAO/EP,BNAO為Al2O3和h-BN)熱導率為1.192?W/mK(為環氧樹脂的654.9%),峰值放熱率為194.9 W/g(為環氧樹脂的33.8%),總放熱量為15.2 kJ/g(為環氧樹脂的54.5%)。此外,PDA-BNAO/EP的粘度為20443?mPa?s,僅為BNAO/EP粘度(102281?mPa?s)的20%。更重要的是,PDA-BNAO/EP具有電子封裝材料所需的良好動態力學性能和電絕緣性能,儲能模量為14.69?Gpa,玻璃化轉變溫度為91.9°C。因此,該復合材料有望廣泛應用于電子封裝中。該研究以“Al2O3/h-BN/epoxy based electronic packaging material with high thermal conductivity and flame retardancy”發表于J. Appl. Polym. Sci.上。
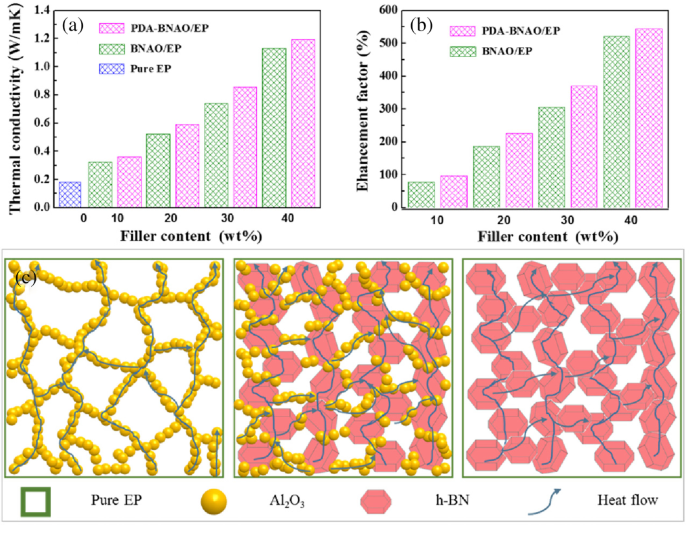
圖1. EP、BNAO/EP和PDA-BNAO/EP的導熱性能比較及熱傳導路徑示意圖
論文鏈接:
https://doi.org/10.1002/app.53291
2、IEEE T. Comp. Pack. Man.:用于寬頻毫米波鍵合線互連的具有埋入式電容的緊湊型片上焊盤結構
近年來,隨著通信技術的快速發展,低成本小型化毫米波封裝在28 GHz本地多點分布服務(LMDS)、60 GHz無線局域網(WLAN)和77 GHz汽車雷達中的應用迅速增長。天線與芯片之間的寬帶低損耗互連是毫米波封裝的關鍵研究領域。
最近,中山大學的研究人員提出一種用于毫米波鍵合線互連的具有埋入式電容的緊湊型片上焊盤結構。該結構通過65 nm互補金屬氧化物半導體(CMOS)工藝實現,能夠補償鍵合線引入的寄生電感。通過金屬堆疊構成的焊盤結構等效于片上串聯電容器。此外,在焊盤的底部負載深N阱結構以減小寄生焊盤對地電容。該焊盤結構用于芯片與芯片之間的互連,其最小插入損耗(insertion loss,IL)為2.179 dB,11.9 GHz的3 dB帶寬為35.6 GHz到47.5 GHz。此外,它還可用于芯片與PCB之間的互連,單側損耗為1.7475 dB,12 GHz的3 dB帶寬為22.7 GHz到34.7 GHz。上述結果表明,這種焊盤結構可以補償鍵合線電感并實現寬帶低損耗阻抗匹配,因此該互聯結構在毫米波頻段的低成本多芯片互連和大規模相控陣集成中具有廣泛的應用前景。該項研究以“A Compact On-chip Pad Structure with an Embedded Capacitor for Broadband Millimeter-wave Bond-wire Interconnection”發表于IEEE T. Comp. Pack. Man.上。

圖2. 芯片與芯片、芯片與PCB互聯的3D模型示意圖
論文鏈接:
DOI: 10.1109/TCPMT.2022.3218593
3、J. Appl. Polym. Sci.:含氟超支化聚硅氧烷的合成及其對環氧樹脂導熱性能的影響
環氧樹脂(EP)作為一種經典的熱固性聚合物,因其優異的機械性能和熱穩定性而廣泛應用于涂料、粘合劑和電子封裝。然而,較差的導熱性在一定程度上限制了其在微電子元件中的應用。
近日,西安大學的研發人員通過溶膠-凝膠工藝和簡易的酯交換工藝分別制備了兩種新型含氟超支化聚硅氧烷(F-HBPSi-1和F-HBPSi-2),然后將這兩種F-HBPSi用作改性劑,與EP相共混,得到兩種新的聚合物體系F-HBPSi-1/EP和F-HBPSi-2/EP。通過測試發現,這兩種F-HBPSi/EP的熱導率和熱穩定性都得到了明顯提高,并且不會影響它們的介電性能。同時,F-HBPSi-2/EP比F-HBPSi-1/EP具有更好的導熱性和熱穩定性,得益于F-HBPSi-2/EP較低的粘度和優異的相容性,以及氟和硅之間的良好協同作用。該方法為應用于微電子領域的高導熱環氧樹脂的開發提供了一條有前景的路徑。該文章以“Synthesis of fluorine contained hyperbranched polysiloxane and their effect on the thermal conductivity of epoxy resins”發表于J. Appl. Polym. Sci.上。
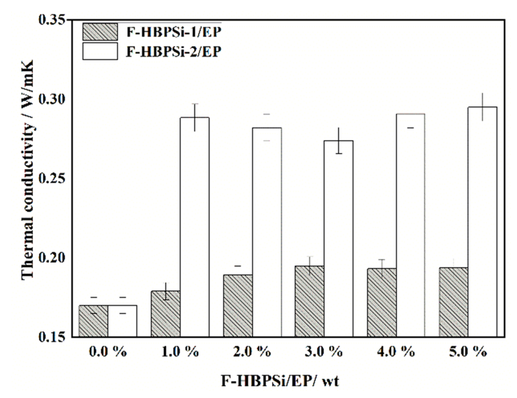
圖3. 不同種類和含量的F-HBPSi/EP的導熱系數
論文鏈接:
https://doi.org/10.1002/app.53315
2
電介質材料
1、Adv. Mater.:調控苯乙烯馬來酸酐共聚物網絡實現全聚合物電介質在高溫下的超高能量密度和充放電效率
聚合物薄膜電容器由于其高功率密度、快速充放電速度和高穩定性等優點,已廣泛應用于電子和電力系統。然而,電導率隨溫度和外加電場的指數增長會顯著降低介電聚合物在高溫下的電容性能。
近日,南方科技大學等機構的研究人員首次報道了通過調控分子結構來控制全有機交聯聚合物中電荷陷阱能級,從而顯著降低高場高溫傳導損耗的實例。這種方法不同于當前引入無機填料的方法,聚合物網絡的交聯結構被優化后,具有7.02 J?cm?3的超高放電能量密度,在150°C下充放電效率大于90%,遠優于當前的介電聚合物和復合材料。實驗和計算證明,不同交聯結構中的電荷俘獲效應是高溫電容性能得到顯著改善的根本原因。此外,聚合物薄膜電容器還具有優異的循環性能和自修復特性。這項工作為能夠在惡劣環境下工作的可擴展高能量密度聚合物電介質的分子結構設計提供了一條有前景的途徑。相關研究以“Tailoring Poly(styrene-co-maleic anhydride) Networks for All-Polymer Dielectrics Exhibiting Ultrahigh Energy Density and Charge-Discharge Efficiency at Elevated Temperatures”發表于Adv. Mater.上。

圖4. 本工作交聯聚合物的性能與文獻對比
論文鏈接:
https://doi.org/10.1002/adma.202207580
3
熱管理材料
1、Nat. Commun.:利用三維導熱網絡和電卡制冷的協同效應在設備原型上對芯片進行熱管理
隨著5G芯片的加速開發,建立高效的散熱結構和對高熱量的精準熱管理成為高功耗電子產品面臨的重大挑戰。
近期,南京大學等機構的研究人員構建了一種具有高導熱路徑的電熱聚合物互穿結構,使聚合物的電熱性能和熱導率分別提高了240%和300%。利用這種電熱復合材料和電磁驅動,研究團隊制造了用于5G芯片的單熱點冷卻的設備原型的放大版。聚合物中嵌入式的連續三維導熱網絡在外加電場下充當有序偶極子的成核位點,有效地在場驅動偶極子熵變化引起的熱點處收集熱能,并打開聲子的高速傳導路徑。因此,兩種組分的協同作用解決了電活性聚合物及其低熱導接觸界面的散熱問題,并且顯著降低了在電熱循環期間切換偶極狀態的電能。該方法為下一代智能微電子器件的精準定點熱管理提供了一種可行的解決方案。該研究以“Thermal management of chips by a device prototype using synergistic effects of 3-D heat-conductive network and electrocaloric refrigeration”發表在Nat. Commun.上。

圖5. 3-3鐵電聚合物/陶瓷復合材料(3-3 PCC)與純聚合物導熱性能比較
論文鏈接:
https://doi.org/10.1038/s41467-022-33596-z
4
電磁屏蔽材料
1、Compos. Part B-Eng.:電場輔助原位制備用于電磁干擾屏蔽的電導率可調的碳/氧化鋯納米復合材料
碳/陶瓷納米復合材料被認為是惡劣環境中用于電磁干擾屏蔽(EMI)的理想候選材料。然而,傳統的碳/陶瓷復合材料制造方法通常復雜、昂貴且耗時。
近日,清華大學的研究人員通過施加直流電場的方法完成了碳/氧化鋯納米復合材料的原位制備。施加直流電場后,在熱壓燒結過程實現了氧化鋯陶瓷中類石墨烯碳納米片(GCN)的直接生長,從而一步得到了具有高電磁屏蔽效率(>40 dB)和高機械強度(>1000 MPa)的GCN/氧化鋯納米復合材料。另外,施加直流電場可以顯著增強燒結過程中的滲碳作用,并且在氧化鋯晶界處原位形成GCN。當初始電場恒定時,可以簡單地通過調節電流密度來控制原位形成的GCN的量,從而得到可調的電導率。這些發現將為碳/陶瓷EMI屏蔽材料和直流電場輔助燒結技術的實驗和理論研究提供新的機會。該研究以“Electric field-assisted in situ fabrication of carbon/zirconia nanocomposites with tunable conductivity for electromagnetic interference shielding applications”發表于Compos. Part B-Eng.上。
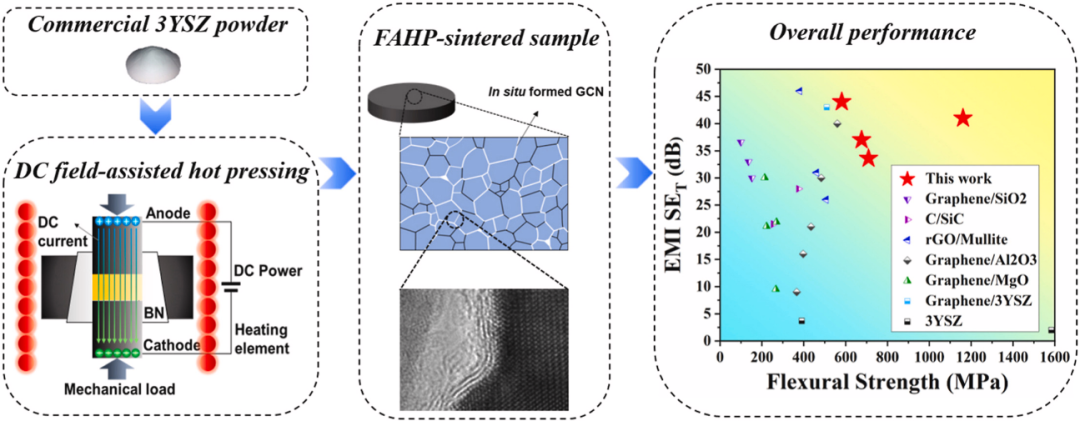
圖6. 外加電場燒結樣品制造過程示意圖及電磁屏蔽效能與文獻對比
論文鏈接:
https://doi.org/10.1016/j.compositesb.2022.110254
5
熱電材料
1、J. Mater. Chem. C:通過簡易可擴展的單步熱蒸發法制備具有超高熱電功率因數的復合SnSe/Bi薄膜
通過熱電效應能夠將熱能直接轉化為電能,因此可以將傳統能源產生的廢熱利用起來,從而提高能源利用效率。
最近,皇家墨爾本理工大學等機構的研究人員報道了一種簡單的復合SnSe/Bi薄膜的制備方法,該薄膜具有超高的功率因數(PF),表現出優異的熱電性能。這種復合薄膜通過熱蒸發技術在Si/SiO2基底上沉積得到,由于BiSe、SnSe和金屬Bi等不同相的存在,復合薄膜表現出n型特征。隨著復合薄膜中Bi質量分數的增加,薄膜的金屬性增強,導致塞貝克系數(S)降低,電導率(σ)增加。Bi含量為25 wt%的復合SnSe/Bi薄膜在580 K時的最大功率因數約為800 μW m-1 K-2。優異的熱電性能使得該薄膜有望應用于自供電可穿戴設備和物聯網領域中。該項研究以“The ultra-high thermoelectric power factor in facile and scalable single-step thermal evaporation fabricated composite SnSe/Bi thin film”發表于J. Mater. Chem. C上。
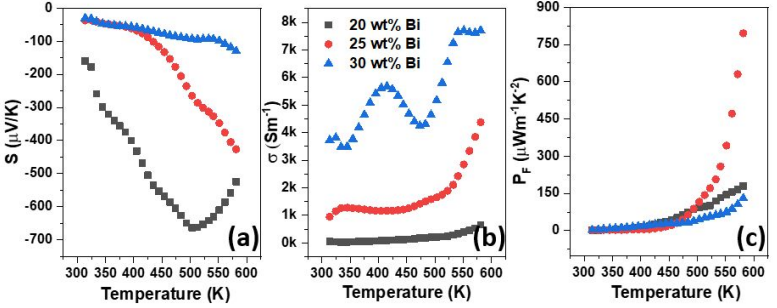
圖7. SnSe/Bi薄膜的塞貝克系數、電導率和功率因數
論文鏈接:
https://doi.org/10.1039/D2TC03719J
圖文 | 戰略研究辦公室
編輯 | 宣傳辦




