跟小編一起來(lái)看看近期國(guó)內(nèi)外電子材料領(lǐng)域都有哪些最新研究進(jìn)展吧~
01 科研動(dòng)態(tài)
1、Nature:用于高溫電容儲(chǔ)能的梯形共聚物
用于高溫下的電容式儲(chǔ)能,介電聚合物需要同時(shí)具有低電導(dǎo)率與高導(dǎo)熱性。這些性質(zhì)看起來(lái)是無(wú)法同時(shí)實(shí)現(xiàn)的,也是現(xiàn)有聚合物基材料面臨的一個(gè)持續(xù)挑戰(zhàn)。
近日,上海交通大學(xué)等機(jī)構(gòu)的研究人員制備得到了一種梯形共聚物,在高電場(chǎng)和高溫下表現(xiàn)出比現(xiàn)有聚合物低一個(gè)數(shù)量級(jí)以上的電導(dǎo)率。梯形共聚物具有5.34 J cm?3的放電能量密度,在200°C時(shí)充放電效率為90%,優(yōu)于現(xiàn)有的介電聚合物和復(fù)合材料。梯形共聚物通過(guò)π-π堆疊相互作用自組裝成高度有序的陣列,從而產(chǎn)生 1.96 ± 0.06 W m?1K?1 的固有平面導(dǎo)熱系數(shù)。共聚物薄膜的高導(dǎo)熱性允許高效的焦耳散熱,因此在高溫和高電場(chǎng)下具有出色的循環(huán)穩(wěn)定性。共聚物還被證明具有擊穿自愈能力,進(jìn)一步表明了梯形結(jié)構(gòu)在極端工作條件的高能量密度聚合物電容器的應(yīng)用前景。該文章以“Ladderphane copolymers for high-temperature capacitive energy storage”發(fā)表于Nature上。
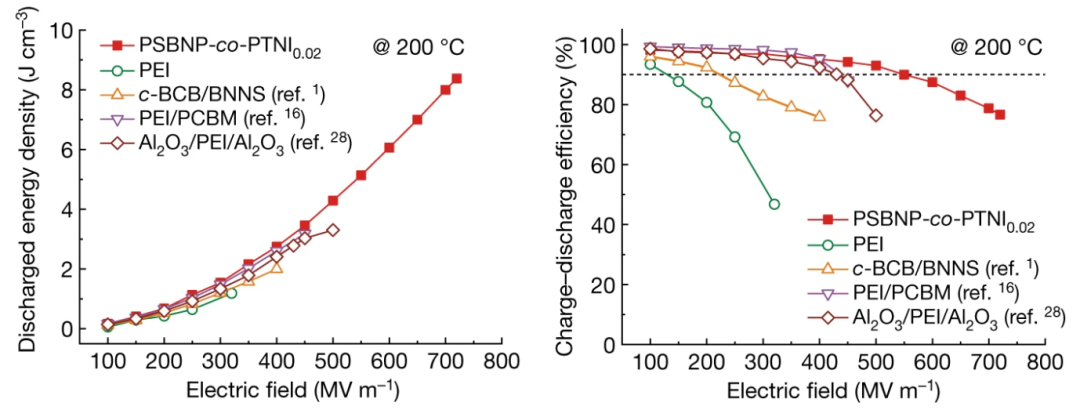
圖1. 不同材料放電能量密度與充放電效率比較
論文鏈接:https://doi.org/10.1038/s41586-022-05671-4
2、Adv. Mater.:超強(qiáng)高韌性熱固性環(huán)氧樹(shù)脂超支化拓?fù)浣Y(jié)構(gòu)和亞納尺度自由體積
熱固性環(huán)氧樹(shù)脂的強(qiáng)度和韌性通常是相互排斥的,高性能和快速可回收性也是如此。實(shí)驗(yàn)測(cè)定的機(jī)械強(qiáng)度值通常遠(yuǎn)低于其理論值。制備具有高模量、高韌性、超強(qiáng)強(qiáng)度和高效可回收性的熱固性環(huán)氧樹(shù)脂仍然是一個(gè)巨大的挑戰(zhàn)。
近日,中南民族大學(xué)等機(jī)構(gòu)的研究人員首次利用點(diǎn)擊化學(xué)技術(shù)將酰亞胺結(jié)構(gòu)引入環(huán)氧樹(shù)脂中,制備了一系列拓?fù)浣Y(jié)構(gòu)可控的超支化聚酰亞胺環(huán)氧樹(shù)脂(Bn),進(jìn)一步將其引入復(fù)合商業(yè)化通用環(huán)氧樹(shù)脂(DGEBA)中。結(jié)果發(fā)現(xiàn),Bn在同時(shí)DGEBA的強(qiáng)度、模量、韌性、耐低溫性和降解性方面表現(xiàn)出優(yōu)異的綜合功能,隨著自由體積分?jǐn)?shù)、自由體積孔尺寸和孔平均尺寸分布的降低,共聚物的強(qiáng)度和韌性呈現(xiàn)出了先增加后降低的變化趨勢(shì)。這種提升歸因于線性和超支化拓?fù)浣Y(jié)構(gòu)的分子混合物的均勻分子空穴或自由體積。另外,首次提出了環(huán)氧樹(shù)脂分子自由體積的精確測(cè)量和控制。該項(xiàng)研究成功解決了強(qiáng)度和韌性之間以及使用時(shí)的高性能和降解時(shí)的高效率之間的兩個(gè)沖突。這些發(fā)現(xiàn)為設(shè)計(jì)超強(qiáng)、高韌和可回收的熱固性環(huán)氧樹(shù)脂提供了一條有效途徑。該文章以“Ultra-Strong and High-Tough Thermoset Epoxy Resins from Hyperbranched Topological Structure and Subnanoscaled Free Volume”發(fā)表于Adv. Mater.上。
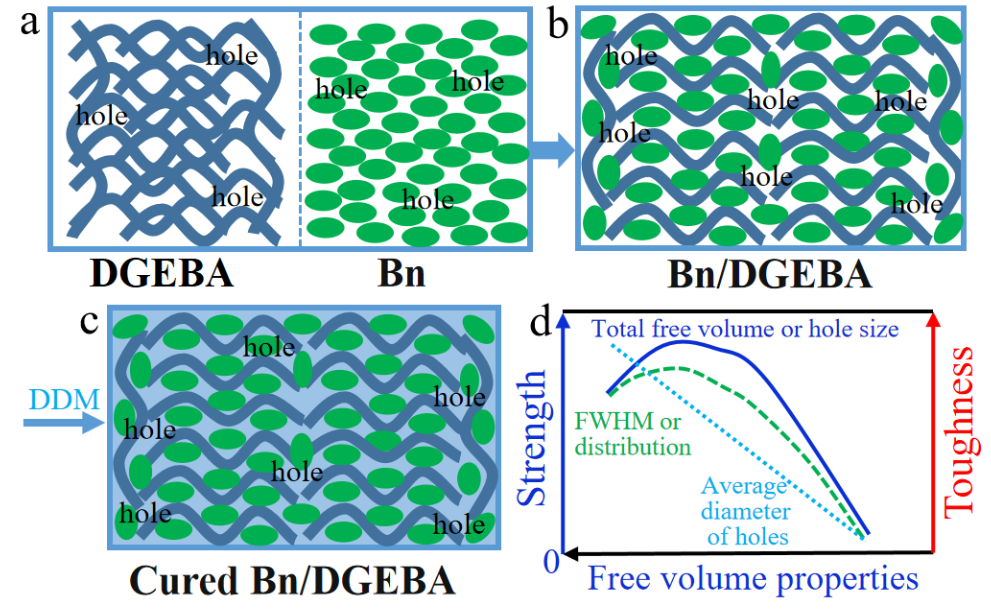
圖2. Bn/DGEBA共聚物的增強(qiáng)增韌機(jī)制
論文鏈接:https://doi.org/10.1002/adma.202308434
3、J. Electron. Packaging:持續(xù)高溫作業(yè)下底部填充膠粘彈性的微觀結(jié)構(gòu)演化
汽車(chē)發(fā)動(dòng)機(jī)罩下電子設(shè)備的工作溫度高達(dá)150–200?°C,使用時(shí)長(zhǎng)接近10?年。消費(fèi)電子產(chǎn)品一般在55–85℃的溫度下運(yùn)行,使用壽命為3-5年。底部填充材料用于為細(xì)間距陣列焊點(diǎn)提供保護(hù),并滿足可靠性要求。
近日,美國(guó)奧本大學(xué)的研究人員將多種不同的底部填充材料置于汽車(chē)發(fā)動(dòng)機(jī)罩溫度下,研究長(zhǎng)時(shí)間等溫暴露對(duì)底部填充膠微觀結(jié)構(gòu)和動(dòng)態(tài)力學(xué)性能的影響。將兩種不同的底部填充材料進(jìn)行三種不同的等溫暴露(低于、接近和高于玻璃化轉(zhuǎn)變溫度),研究了儲(chǔ)能模量、損耗模量、tanδ等動(dòng)態(tài)力學(xué)粘彈性及其各自的玻璃化轉(zhuǎn)變溫度。研究人員采用偏光顯微鏡測(cè)量氧化層厚度,對(duì)底部填充膠的氧化行為進(jìn)行了實(shí)驗(yàn)研究,并利用動(dòng)態(tài)力學(xué)分析儀(DMA)研究了底部填充膠的動(dòng)態(tài)力學(xué)性能對(duì)其力學(xué)性能的影響。結(jié)果表明,等溫老化會(huì)使底部填充物氧化,從而顯著改變材料的力學(xué)性能。該研究為底部填充膠材料老化失效行為提供了參考。該文章以“Microstructural Evolution of Viscoelastic Properties of Underfills Under Sustained High Temperature Operation”發(fā)表于J. Electron. Packaging上。

圖3. 150℃老化下不同時(shí)間底部填充膠的氧化層
論文鏈接:https://doi.org/10.1115/1.4052715
4、J. Electron. Packaging:氮化硼/環(huán)氧樹(shù)脂復(fù)合材料對(duì)倒裝芯片可靠性的影響
在電-熱-機(jī)械耦合的作用下,容易發(fā)生電子器件的故障和性能下降,已成為微電子封裝中一個(gè)重大的可靠性問(wèn)題。
近日,中南大學(xué)等機(jī)構(gòu)的研究人員研究了利用熱界面材料(TIM)提高倒裝芯片可靠性的方法。首先,建立了倒裝芯片封裝系統(tǒng)的三維有限元模型,并對(duì)電-熱力多場(chǎng)耦合進(jìn)行了有限元模擬。然后,分析了高電流密度下倒裝芯片的焦耳熱、溫度分布、熱應(yīng)力和變形。同時(shí),研究了TIM的導(dǎo)熱系數(shù)和工作電流對(duì)倒裝芯片可靠性的影響。結(jié)果表明,當(dāng)TIM的熱導(dǎo)率從0.2 W/m·K增加至6?W/m·K時(shí),倒裝芯片的最高溫度和最大等效應(yīng)力分別降低了6.35?°C和14.6?MPa。最后,通過(guò)實(shí)驗(yàn)與仿真相結(jié)合的方法,分析了熱界面材料對(duì)倒裝芯片可靠性的影響。進(jìn)一步證實(shí)了制備的高導(dǎo)熱氮化硼納米片/環(huán)氧樹(shù)脂復(fù)合材料有效地提高了電子器件的可靠性和使用壽命。該文章以“Effect of Hexagonal-Boron Nitride/Epoxy and BNNS/Epoxy Composite Materials on the Reliability of Flip Chip”發(fā)表于J. Electron. Packaging上。
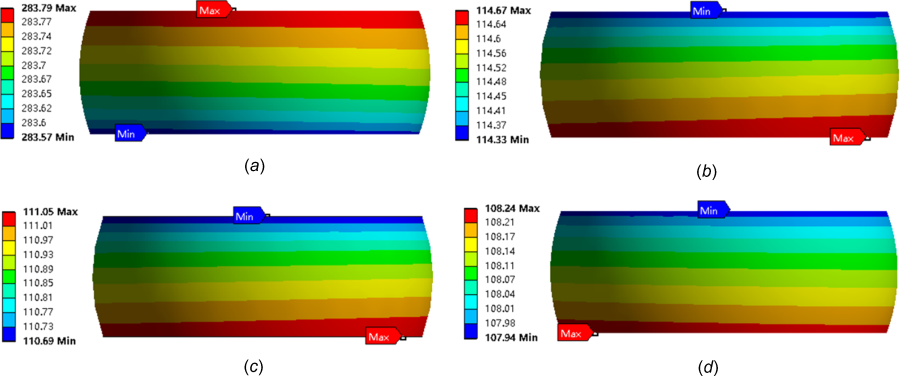
圖4. 倒裝芯片焊點(diǎn)的溫度分布:
(a)無(wú)TIM(b)、(c)、(d)TIM 熱導(dǎo)率分別為0.2、0.5?、6? W/m·K
論文鏈接:https://doi.org/10.1115/1.4051468
02 技術(shù)動(dòng)態(tài)
1、關(guān)于Intel玻璃基板的簡(jiǎn)要介紹
此前,英特爾(Intel)在其年度發(fā)布會(huì)上宣布,到2030年,將實(shí)現(xiàn)在一塊封裝芯片中集成1萬(wàn)億個(gè)晶體管,同時(shí)會(huì)上還展示了有關(guān)玻璃基板的更多細(xì)節(jié)。另外,在加利福尼亞州圣何塞舉行的“英特爾創(chuàng)新”活動(dòng)上,Intel宣布玻璃基板將在這個(gè)十年的后半程實(shí)現(xiàn)商業(yè)首發(fā)。本文將簡(jiǎn)單介紹什么是玻璃基板以及它與傳統(tǒng)有機(jī)基板的不同之處。
(1)玻璃基板是一項(xiàng)全新的技術(shù)
圖5為Intel展示的一顆功能齊全的測(cè)試芯片,該芯片使用75 μm的玻璃通孔(TGV),橫縱比為20:1,核心厚度為1 mm。大概十年前,Intel這家半導(dǎo)體巨頭公司就開(kāi)始進(jìn)行玻璃基板方面的研發(fā)工作,至今投入已經(jīng)超10億美元,研發(fā)團(tuán)隊(duì)約600人規(guī)模,同時(shí)還建立了一條全新的生產(chǎn)線。

圖5. Intel展示的使用玻璃基板的測(cè)試芯片
玻璃基板可以實(shí)現(xiàn)比傳統(tǒng)有機(jī)基板更緊密的信號(hào)間距,對(duì)于服務(wù)器或數(shù)據(jù)中心使用的高功耗大芯片來(lái)說(shuō),使用玻璃基板在速率和功耗方面都具有一定優(yōu)勢(shì)。同時(shí),隨Chiplet概念的發(fā)展,玻璃基板也有助于將更多芯粒封裝到一個(gè)系統(tǒng)中。
(2)技術(shù)優(yōu)點(diǎn)
玻璃的成分主要是二氧化硅,在高溫下性質(zhì)更加穩(wěn)定。由于高性能芯片往往散熱量巨大,玻璃基板在高溫下的熱穩(wěn)定性和機(jī)械穩(wěn)定性將使芯片的熱管理變得更加高效。其次,為避免封裝在生產(chǎn)過(guò)程中彎曲,小芯片之間必須要有非常高密度的互聯(lián),而玻璃基板可滿足更高的互聯(lián)密度需求。另外,玻璃具有更高的平坦度,這也將使得光刻和封裝變得更加容易。Intel內(nèi)部消息稱使用玻璃基板可以使圖案的失真降低50%,以提高光刻的聚焦深度,從而使半導(dǎo)體制造更加精確。
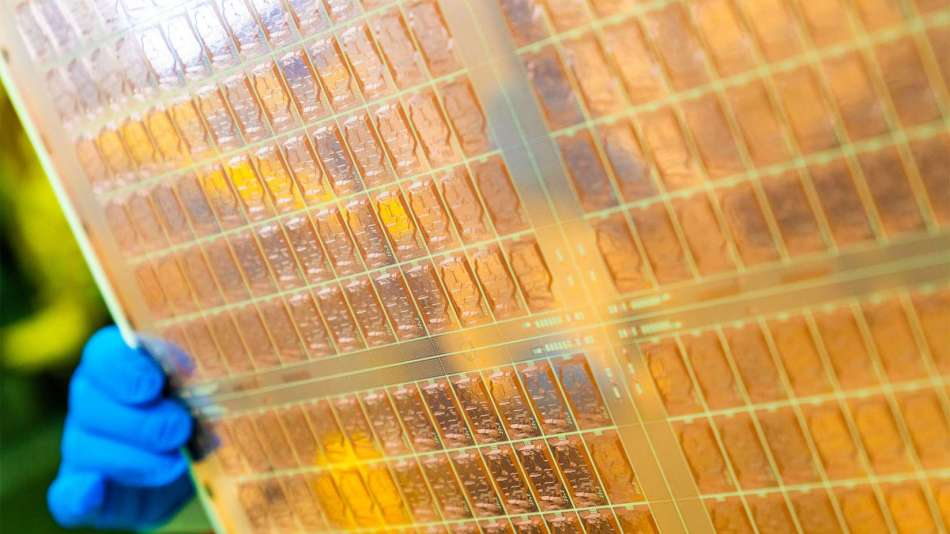
圖6. Intel玻璃基板
(3)與封裝和Chiplet的聯(lián)系
玻璃基板的提出與先進(jìn)封裝和Chiplet概念密不可分。基板是用來(lái)承載芯片的介質(zhì),是芯片封裝的重要部分,基板除了可以確保芯片的結(jié)構(gòu)穩(wěn)定性,還扮演將信號(hào)從芯片內(nèi)部傳輸?shù)椒庋b結(jié)構(gòu)的角色。因此玻璃基板的優(yōu)越機(jī)械性能和高互聯(lián)密度將助力產(chǎn)生更高性能的芯片封裝。
玻璃基板尤其適用于Chiplet概念,可以將更多的晶體管容納到一個(gè)封裝結(jié)構(gòu)中。得益于玻璃基板的更高互聯(lián)密度,同樣大小的基板可容納更多芯粒之間的連接。換句話說(shuō),可以在同樣的封裝中集成更多的芯粒。

圖7. 玻璃基板是對(duì)先進(jìn)封裝技術(shù)的補(bǔ)充
(4)應(yīng)用時(shí)機(jī)
玻璃基板除了能克服諸如互聯(lián)密度和耐高溫等方面的挑戰(zhàn)之外,在制造用于數(shù)據(jù)人工智能(AI)和高性能計(jì)算(HPC)的大芯片時(shí),機(jī)械和電氣性能方面也比有機(jī)基板優(yōu)越,可以承載的功率和數(shù)據(jù)互聯(lián)是有機(jī)基板的10倍。Intel認(rèn)為,在未來(lái)幾年內(nèi),使用有機(jī)材料在硅封裝上擴(kuò)增晶體管將達(dá)到極限,玻璃基板將是半導(dǎo)體行業(yè)下一步重要發(fā)展方向。
(5)需要考慮的問(wèn)題
Intel的技術(shù)開(kāi)發(fā)執(zhí)行副總裁Ann Kelleher認(rèn)為玻璃基板的技術(shù)創(chuàng)新已經(jīng)完成,接下來(lái)需要考慮生產(chǎn)成本問(wèn)題。不像有機(jī)基板經(jīng)過(guò)大量的測(cè)試和長(zhǎng)期的應(yīng)用,玻璃基板的生產(chǎn)和應(yīng)用將更加昂貴,將在初期面臨收益率問(wèn)題。更為重要的是,玻璃基板需要建立一套商業(yè)生產(chǎn)生態(tài)系統(tǒng),包括必要的生產(chǎn)工具和供應(yīng)能力。這也是Intel與玻璃處理設(shè)備與材料供應(yīng)商之間密切合作的原因。另外Intel還需要為這種新型基板的封裝測(cè)試尋找外包商。
一家總部位于加州的芯片制造商計(jì)劃適時(shí)向Intel晶圓代工廠提供玻璃基板,并有信心將成本降至與現(xiàn)有有機(jī)基板同等水平。同時(shí)Intel認(rèn)為玻璃基板和有機(jī)基板在未來(lái)幾年將共存一段時(shí)間。
總的來(lái)說(shuō),玻璃基板將是一次重大的技術(shù)轉(zhuǎn)型,將為Intel的技術(shù)競(jìng)爭(zhēng)力帶來(lái)飛躍,尤其是在為人工智能和數(shù)據(jù)中心服務(wù)的高端芯片方面。
(source: five facts you need to grasp to understand Intel’s glass substrate, EDN)




