1 電介質材料
1、Adv. Mater.:用于高溫電容儲能的可擴展聚酰亞胺-聚酰胺酸共聚物基納米復合材料
下一代電力系統和電子設備的發展對高溫(~150℃)、高能量密度、高效率、可擴展和低成本的聚合物基介質電容器提出迫切需求。
近日,中國科學技術大學的研究人員設計并合成了一種含有極少量氮化硼納米片的聚酰亞胺-聚酰胺酸共聚物基納米復合材料。在混合動力汽車200 MV m-1和150℃的實際工作條件下,可實現1.38 J cm-3的高能量密度和超過96%的高效率,約為商用BOPP室溫能量密度的2.5倍(200 MV m-1下為0.39 J cm-3)。經過20000次充放電循環試驗和35天高溫耐久性試驗后,這種材料在150℃下的能量密度和效率沒有退化跡象。該研究為開發高溫聚合物基電容器提供了一種有效且低成本的策略。相關研究工作以“Scalable Polyimide-poly(Amic Acid) Copolymer Based Nanocomposites for High-Temperature Capacitive Energy Storage”為題發表于Adv. Mater.上。
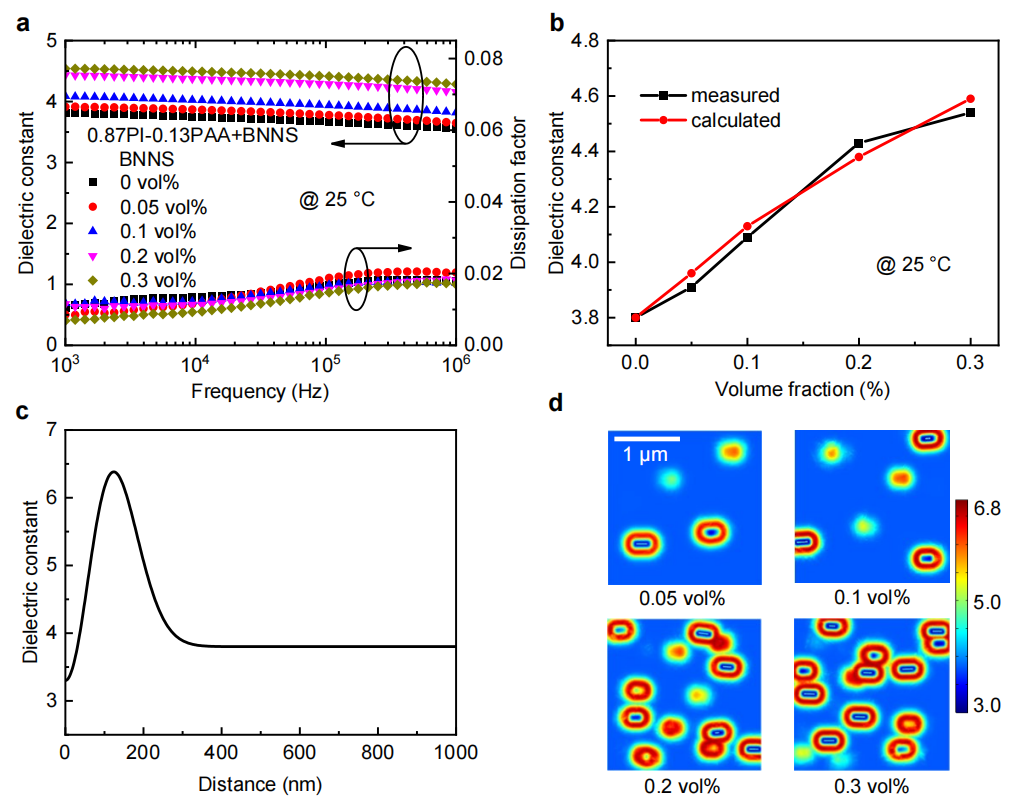
圖1. 含有BNNS的納米復合材料的介電性能
論文鏈接:
https://doi.org/10.1002/adma.202101976
2、J. Eur. Ceram. Soc.:Mg4Nb2O9-ZnAl2O4-TiO2三相低介電損耗陶瓷
低介電常數介質陶瓷是用于毫米波通信和微波陶瓷基板的核心關鍵材料。隨著介電常數的降低,信號傳輸速度增加。毫米波應用需要具有溫度穩定性、低介電常數和高Qxf值的介質陶瓷。高Qxf值可以最大限度地降低電路插入損耗,并可用于高選擇性濾波器。尋找高溫穩定、低介電常數、高Qxf值、低成本的新型微波介質陶瓷一直是研究的焦點。
最近,臺灣成功大學的研究人員采用傳統的固相反應方法,在0.7Mg4Nb2O9-(0.3-x)ZnAl2O4-xTiO2三元體系中制備了一系列復合陶瓷,并對其晶相、微觀結構、介電性能等進行了系統研究。研究表明,Ti4+的加入取代了Mg4Nb2O9結構中的Nb5+,這促進了Mg4Nb2O9在燒結過程中分解形成第二相Mg5Nb4O15。ZnAl2O4-TiO2共摻雜的協同效應促進了Mg4Nb2O9陶瓷的致密化。x=0.15-0.2的樣品介電常數為13-14,大于ZnAl2O4、Mg4Nb2O9和Mg5Nb4O15的介電常數,這是由于Mg4Nb2O9和Mg5Nb4O15中Al3+/Ti4+取代Nb5+導致的NbO6八面體畸變造成的。ZnAl2O4和TiO2的共摻雜增強了NbO6八面體的長程有序性,從而提高了Qxf值。1300℃燒結的0.7Mg4Nb2O9-0.15ZnAl2O4-0.15TiO2樣品介電常數為13.1,Qxf值為366000 GHz,τf值為-60.8 ppm/℃,是微波電子器件應用的良好候選材料。相關研究內容以“Low dielectric loss ceramics in the Mg4Nb2O9-ZnAl2O4-TiO2 ternary system”發表于J. Eur. Ceram. Soc.上。

圖2. 1300℃燒結的Mg4Nb2O9、MZT015樣品的拉曼光譜
論文鏈接:
https://doi.org/10.1016/j.jeurceramsoc.2021.10.059
3、Chem. Eng. J.:通過引入Ba(Mg1/3Nb2/3)O3提高(Na0.5Bi0.5)0.7Sr0.3TiO3基弛豫鐵電體的儲能和硬度
大儲能密度(Wrec)、高效率(η)、高硬度(H)和大工作溫度范圍等綜合性能是現代電子電力系統應用的主要挑戰。
最近,四川大學的研究人員開發了一種無鉛(Na0.5Bi0.5)0.7Sr0.3TiO3基(BNST)陶瓷,實現了優異的綜合儲能性能(5.50 J/cm3的高Wrec值,90.10%的高效率,20-200℃的寬使用溫度范圍和7.35 GPa的超高硬度)。研究表明,提高介電擊穿強度(Eb)、降低早期極化飽和和大極化差、減小晶粒尺寸有利于綜合性能的提高。通過密度泛函理論(DFT)的第一性原理計算對本征電子結構的進一步分析表明,Ba(Mg1/3Nb2/3)O3(BMN)的引入有助于提高BNST的Eb值,這也通過實驗得到了驗證。壓電響應力顯微鏡(PFM)和Vogel-Fulcher(V-F)模型證明體系中存在顯著的疇弛豫行為,這為抑制早期極化飽和和大極化差提供了有力的證據。此外,在實際應用中,這種BNST基陶瓷表現出大功率密度(49.26 MW/cm3)、快速放電時間(~120.00 ns)和較寬的溫度范圍(20-140℃)。該研究為獲得高性能的脈沖功率電容器提供了有效的指導方法。相關研究工作以“Enhancement of energy storage and hardness of (Na0.5Bi0.5)0.7Sr0.3TiO3-based relaxor ferroelectrics via introducing Ba(Mg1/3Nb2/3)O3”發表于Chem. Eng. J.上。

圖3.通過引入Ba(Mg1/3Nb2/3)O3提高(Na0.5Bi0.5)0.7Sr0.3TiO3基弛豫鐵電體的儲能和硬度
論文鏈接:
https://doi.org/10.1016/j.cej.2021.133441
2 熱管理材料
1、Chem. Mater.:具有高跨平面熱導率和優異彈性柔度的熱界面材料
隨著微處理器向更高功率、更大芯片和更高頻率的方向發展,散熱成為核心問題之一。熱界面材料(TIM)用于芯片和散熱片、散熱片和熱沉之間,在微處理器冷卻中發揮著越來越重要的作用。目前,大多數研究主要涉及TIM的熱導率。對于熱設計,彈性柔度也很重要,因為良好的彈性柔度可以降低接觸熱阻,并緩解應力集中引起的翹曲破壞。然而,在TIMs中,高導熱性和良好的彈性柔度通常是互斥的。
最近,深圳先進電子材料國際創新研究院的研究人員及其合作者開發了一種由垂直取向石墨和聚丁二烯制成的TIM,這種材料具有64.90 W·m-1·K-1的高跨平面熱導率,在50%壓縮應變下表現出優異的彈性柔度(僅93 kPa應力),類似于軟生物組織,并具有優異的壓縮回彈性能(儲能模量220 kPa,力學損耗因子0.226)。這些優異的性能源于石墨膜在聚丁二烯中的垂直取向、石墨膜與聚丁二烯之間的強界面強度,以及通過交叉堆疊技術將石墨對聚丁二烯固有機械性能的負面影響降至最低。將該TIM材料應用于CPU,其與聚丁二烯相比,表現出卓越的散熱性能,芯片溫度降低高達158℃。這項研究為高性能計算(如GPU、AI計算和云計算)提供了一種符合特定要求的高性能TIM材料。相關研究工作以“Thermal Interface Materials with Both High Through-Plane Thermal Conductivity and Excellent Elastic Compliance”發表于Chem. Mater.上。深圳先進電子材料國際創新研究院熱管理材料研究中心在讀碩士研究生李俊偉為第一作者,中心執行主任曾小亮副研究員和葉振強助理研究員為共同通訊作者。

圖4.具有高跨平面熱導率和優異彈性柔度的熱界面材料
論文鏈接:
https://doi.org/10.1021/acs.chemmater.1c03275
3 熱電材料
1、Mater. Today Phys.:利用低角度晶界提高n型碲化鉍基多晶材料的室溫熱電性能
Bi2Te3基熱電材料廣泛應用于室溫附近的固態制冷。然而,一次燒結制備的n型Bi2Te3基多晶材料的室溫熱電優值(zT)始終低于0.8。
最近,浙江大學的研究人員通過簡單的分步熱壓工藝(一次燒結)在n型Bi2Te2.7+xSe0.3中引入了低角度晶界(low-angle grain boundaries,LAGB),并通過掃描透射電子顯微鏡對其進行了表征。LAGBs由可以有效散射中頻聲子的位錯陣列組成,從而抑制晶格熱導率。雖然LAGBs也可以作為低能電子的散射中心,降低載流子遷移率,但由于散射因子的增加,它們可能有助于提高Seebeck系數。總的來說,在相同的功率因數水平下,具有LAGBs的樣品具有更低的電子熱導率。最后,在n型Bi2Te2.7Se0.3中獲得了0.94的高室溫zT值,與多次燒結的樣品性能相當。此外,分步熱壓還能有效提高p型Bi2Te3基多晶材料的室溫zT值(~1.2)。 這項工作提出了一種新的簡單方法來構建Bi2Te3基合金中的LAGB,以提高其zT值,并揭示了LAGB如何影響電輸運和熱輸運性能的潛在機制。相關研究內容以“Enhancing the Room Temperature Thermoelectric Performance of n-Type Bismuth-Telluride-Based Polycrystalline Materials by Low-Angle Grain Boundaries”發表于Mater. Today Phys.上。

圖5.利用低角度晶界提高n型碲化鉍基多晶材料的室溫熱電性能
論文鏈接:
https://doi.org/10.1016/j.mtphys.2021.100573
2、ACS Nano:通過引入Cu2Te納米晶和共振能級摻雜實現GeTe合金的超低晶格熱導率和高熱電性能
二元化合物GeTe作為一種潛在的中溫熱電材料引起了人們的廣泛關注。
近期,南京大學和南京理工大學的研究人員開發了一種具有超低晶格熱導率和高熱電性能的In、高含量Cu共摻雜GeTe熱電材料。In摻雜通過引入共振能級提高了GeTe費米表面附近的態密度,從而使Seebeck系數顯著增大。In和Cu共摻雜不僅優化了載流子濃度,而且由于Ge空位的減少,還顯著地將載流子遷移率提高到87 cm2 V-1 s-1。在Ge1.04-x-yInxCuyTe系列中,增強的Seebeck系數連同顯著增強的載流子遷移率導致PF顯著增強。此外,通過合金化高含量的Cu,將Cu2Te納米晶的第二相引入到GeTe中,Cu2Te納米晶和高密度的位錯引起強烈的聲子散射,顯著降低晶格熱導率。在823K時,晶格熱導率降低至0.31W m-1K-1,這不僅低于GeTe的非晶態極限,而且與具有強晶格非諧性或復雜晶體結構的熱電材料相當。因此,Ge0.9In0.015Cu0.125Te通過去耦GeTe的電子和聲子輸運,最終獲得了2.0的高ZT值。該研究工作展現了聲子工程在推進高性能GeTe熱電材料方面的重要性。這一研究工作以“Achieving Ultralow Lattice Thermal Conductivity and High Thermoelectric Performance in GeTe Alloys via Introducing Cu2Te Nanocrystals and Resonant Level Doping”發表于ACS Nano上。

圖6. 通過引入Cu2Te納米晶和共振能級摻雜實現GeTe合金的超低晶格熱導率和高熱電性能
論文鏈接:
https://doi.org/10.1021/acsnano.1c05650
5 電磁屏蔽材料
1、Mater. Horiz.:漸進式導電模塊化設計實現多級復合泡沫高效微波吸收和屏蔽的集成
具有優異吸波性能的超高效電磁干擾(EMI)屏蔽復合材料是消除微波污染的理想解決方案。然而,吸波材料和電磁屏蔽材料的集成是一個困難的挑戰,因為它們有著不同的設計策略。
近日,中北大學和深圳先進電子材料國際創新研究院的研究人員提出一種基于漸進導電模塊化設計實現高效吸收和屏蔽能力的策略,并制備得到了具有定向多孔結構的還原氧化石墨烯@四氧化三鐵/碳納米管/四針狀氧化鋅晶須@銀/水性聚氨酯(rGO@Fe3O4/CNT/T-ZnO@Ag)多級復合泡沫,其在8.2-18.0 GHz的頻率范圍內表現出>92.3 dB的平均EMI SE值和顯著的微波吸收性能(反射損耗<-10 dB),平均反射屏蔽效能(SER)和反射率(R)分別低至0.065 dB和0.015。此外,通過電磁模擬建立了復合泡沫的形貌結構與電磁波衰減機理之間的關系。這種具有電磁波吸收和屏蔽特性的復合泡沫具有重量輕、填料消耗少、性能高、結構可設計、屏蔽機制可調等特點,具有良好的應用前景。該研究工作以“Integrating Efficient Microwave Absorbing and Shielding in a Multistage Composite Foam with Progressive Conductivity Modular Design”發表于Mater. Horiz.上。深圳先進電子材料國際創新研究院許亞東助理研究員為第一作者,電磁屏蔽材料研究中心執行主任胡友根副研究員為共同通訊作者。
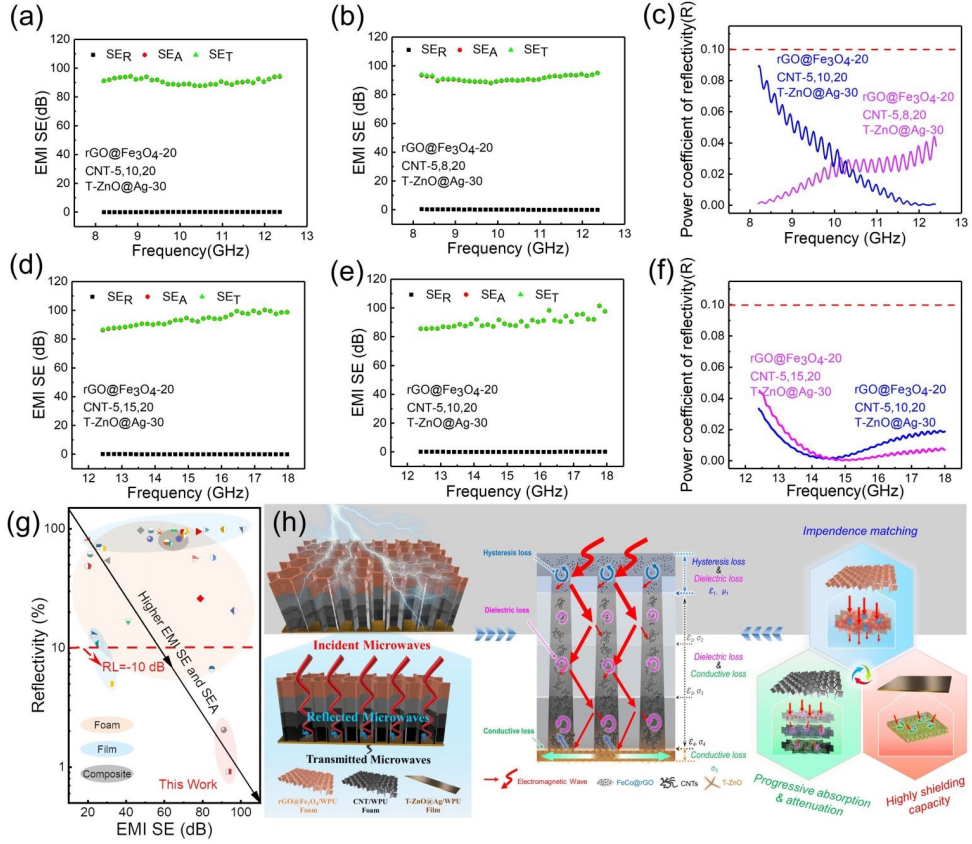
圖7. 不同填料含量復合泡沫的電磁屏蔽性能
論文鏈接:
https://doi.org/10.1039/D1MH01346G
6 先進電子封裝材料與電子材料
1、IEEE Trans. Comp. Packag. Man. Tech.:扇出型晶圓級封裝用光敏聚酰亞胺的選型與表征
扇出型晶圓級封裝(FOWLP)是目前最流行的微電子封裝技術之一。再布線層(RDL)用于將芯片焊盤擴展到芯片邊緣之外。光敏聚酰亞胺(PSPI)廣泛應用于RDLs的制作,但它也會在熱循環試驗或高加速應力試驗期間引入一些問題,例如翹曲、剝落、起泡,甚至開裂。
為了在材料選型階段降低這些風險,中國科學院微電子研究所和中國科學院大學的研究人員研究了四種常見的介電材料(聚酰亞胺A、B、C和酚醛樹脂D)的熱機械性能和表面特性,并進行了工藝改進實驗設計。結果表明,與其他材料相比,材料A具有優異的延伸率(超過30%),可接受的固化溫度(低于260℃)和低熱膨脹系數(52 ppm/K),更適合用作RDLs的介質材料。這一研究工作以“Selection and Characterization of Photosensitive Polyimide for Fan-out Wafer-Level Packaging”發表于IEEE Trans. Comp. Packag. Man. Tech.上。
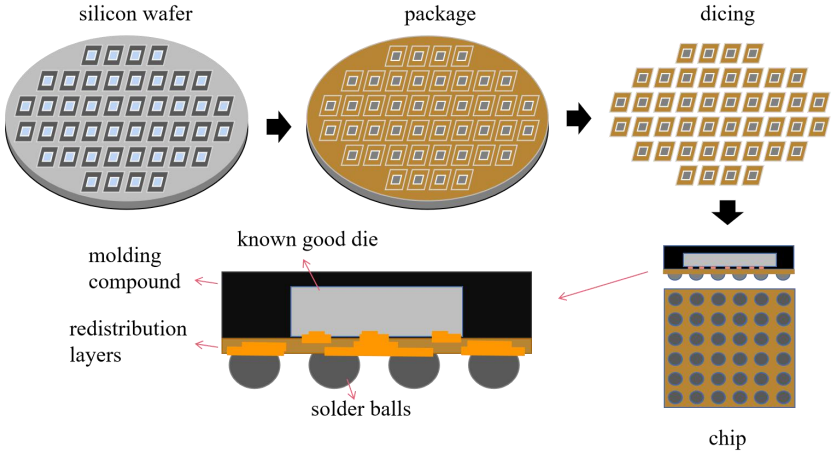
圖8. 扇出型晶圓級封裝工藝與結構
論文鏈接:
DOI: 10.1109/TCPMT.2021.3127235
2、Compos. Sci. Tech.:利用微米級金剛石防止界面電荷積累提高導熱環氧復合材料的介電強度
環氧樹脂基介電材料在制造先進的電力電子器件中起著至關重要的作用。然而,由于器件小型化和高功率密度導致高電壓應力和高發熱密度,環氧復合材料必須具有高介電強度和導熱性。
最近,合肥工業大學的研究人員提出一種防止無機填料-環氧樹脂基體界面上的界面電荷積聚,從而提高介電強度的通用策略,并使用微米級金剛石開發了一種高導熱環氧復合材料。這種環氧復合材料的介電強度和熱導率顯著提高,同時沒有對微米級金剛石表面進行任何額外的物理化學改性。所制備的金剛石/環氧樹脂復合材料具有較低的相對介電常數和優異的力學、熱學和加工性能,可用于制造高電壓應力和高發熱密度的電力電子器件。該研究成果以“Enhancing dielectric strength of thermally conductive epoxy composites by preventing interfacial charge accumulation using micron-sized diamond”發表于Compos. Sci. Tech.上。
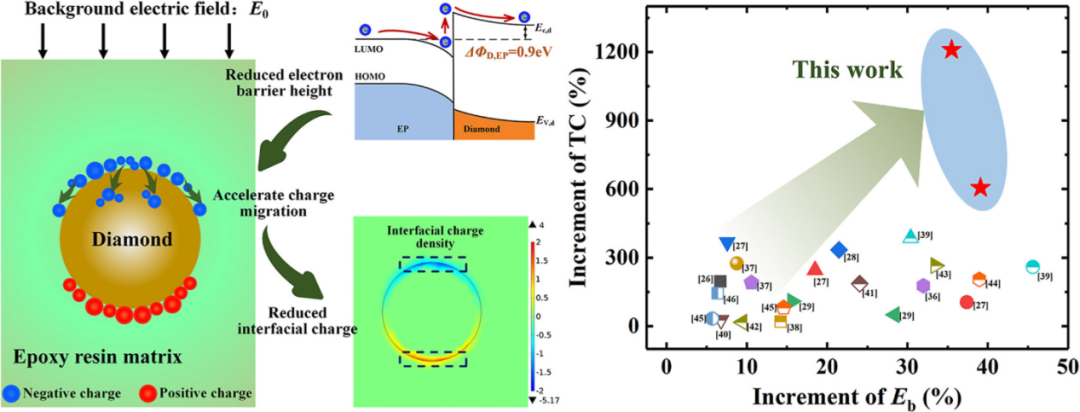
圖9. 利用微米級金剛石防止界面電荷積累提高導熱環氧復合材料的介電強度
論文鏈接:
https://doi.org/10.1016/j.compscitech.2021.109178
3、IEEE Trans. Comp. Packag. Man. Tech.:集成電路塑封過程中環氧塑封料填料堵塞模擬
隨著集成電路組件在封裝中變得越來越密集和更小,許多問題亟待解決。在塑封填充過程中,由于EMC含有約80 wt%的二氧化硅填料,如果組件和基板之間的間隙高度太小,填料可能會堵塞間隙的澆口。由于間隙中的樹脂含量較高,這種堵塞會導致爆米花效應。
為了確定EMC填充過程以及間隙高度和填料尺寸之間的關系,臺灣成功大學和日月光半導體制造股份有限公司的研究人員使用模流分析軟件和CFD-DEM耦合方法模擬了模腔中EMC的填充過程、EMC填料濃度分布與EMC填料的運動,以確定間隙高度和填料尺寸之間的關系以及影響填料堵塞的因素。結果表明,間隙澆口處的填料濃度高于其他區域,30 μm間隙高度模型間隙澆口處的填料濃度高于50 μm間隙高度模型。根據DEM-CFD耦合結果,單個直徑大于間隙高度一半的顆粒會導致間隙澆口堵塞,而平均粒徑大于間隙高度三分之一的顆粒也會導致間隙澆口堵塞。該研究工作以“Epoxy Molding Compound Filler Clogging Simulation during Integrated Circuit Encapsulation Process”發表于IEEE Trans. Comp. Packag. Man. Tech.上。
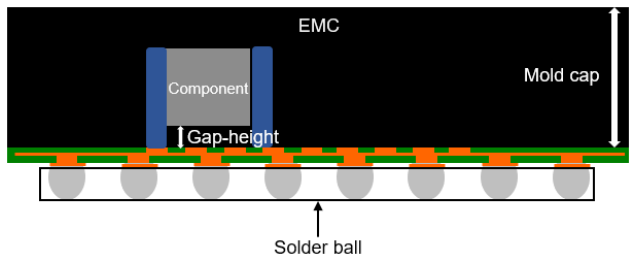
圖10. 塑封結構示意圖
論文鏈接:
DOI: 10.1109/TCPMT.2021.3129886
4、J. Electron. Packag.:倒裝芯片封裝小型化的解析多參數設計優化
微電子工業的飛速發展對更小、更緊湊、性能更高的封裝器件提出了需求。
最近,馬來西亞理科大學的研究人員針對倒裝芯片封裝的小型化提出了一種解析多參數設計優化方法,同時考慮了后續底部填充過程的填充時間。這種設計優化方法基于最新的區域分離填充時間分析模型,并通過數值模擬驗證了所建立的分析模型。填充時間的差異小于9.9%,預測的臨界凸點間距僅偏差4.1%,證實了分析模型和數值模型的一致性。研究人員深入分析了凸點間距、間隙高度和接觸角的變化對填充時間的影響,計算了臨界凸點間距和臨界間隙高度,并將其擬合到各自的經驗方程中。隨后,提出了一種新的基于底部填充參數閾值和臨界性的多參數設計優化方法,以獲得最緊湊倒裝芯片封裝的最佳參數,確定在塑封過程中可接受的低填充時間。最后,研究人員在先前公布的底部填充實驗中使用的四個倒裝芯片上對所提出的優化技術進行了測試。相關研究工作以“Analytical Multi-Parametric Design Optimization for the Miniaturization of Flip-Chip Package”發表于J. Electron. Packag.上。
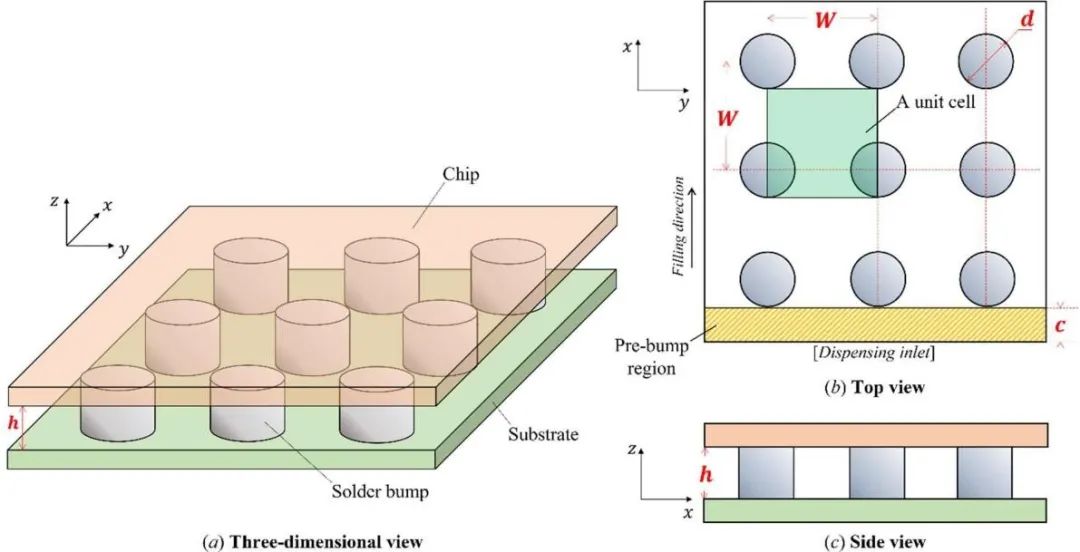
圖11. 倒裝芯片封裝及其設計參數示意圖
論文鏈接:
https://doi.org/10.1115/1.4052920
5、ACS Appl. E.Mater. :功率器件封裝用低溫燒結銀納米片漿料及其各向異性燒結機理
燒結銀漿由于其優異的導電性和導熱性,已成為寬帶隙(WBG)功率器件的一種封裝材料。
近日,深圳先進電子材料國際創新研究院的研究人員開發了一種含有單分散三角形銀納米片(尺寸分布40?260 nm)的銀漿,其燒結銀接頭(silver joints)的剪切強度高達49.8 MPa,大于傳統銀漿的剪切強度,孔隙率相對較低,僅為5.1%。這些顯著的性能歸因于銀納米片特殊的各向異性燒結過程和橋接效應。銀納米片的各向異性燒結是指在燒結過程中角部、邊緣和表面的連續變形。特別是,表面變形為銀原子提供了較大的擴散路徑,從而形成更致密的燒結銀接頭。由單個銀納米片連接的兩個單獨的銀納米片產生的橋接效應增加了銀納米片之間的連接,從而改善了燒結銀接頭的機械性能。這種各向異性的燒結機理和橋接效應將啟發其他研究人員研究其他材料的燒結機理,并優化這些材料相應漿料的性能。相關研究工作以“Low Temperature Sintered Silver Nanoflake Paste for Power Device Packaging and Its Anisotropic Sintering Mechanism”發表于ACS Appl. Mater. es上。深圳先進電子材料國際創新研究院在讀博士研究生王春成、李剛高級工程師為該論文的共同第一作者,芯片級封裝材料研究中心執行主任朱朋莉研究員和李剛高級工程師為共同通訊作者。
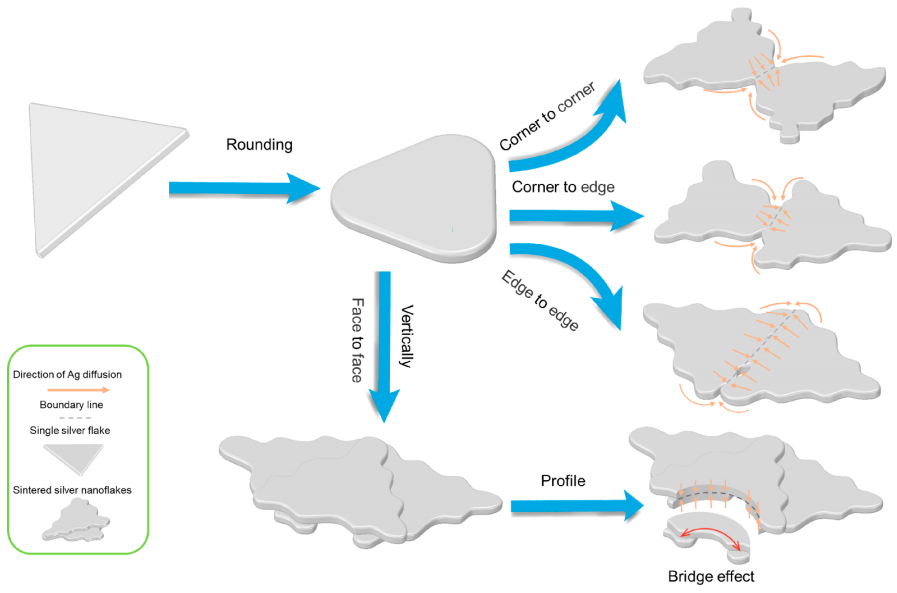
圖12. 銀納米片的燒結過程
論文鏈接:
https://doi.org/10.1021/acsaelm.1c00857
文字 | 科研管理辦
編輯 | 公共關系與宣傳辦




