1 電介質材料
1、ACS Appl. Mater. Interfaces:通過穩定反鐵電相和增強弛豫行為實現無鉛(Bi0.9Na0.1)(Fe0.8Ti0.2)O3改性NaNbO3陶瓷的超高儲能密度和高效率
介質電容器因在先進大功率和/或脈沖功率電子器件中的重要應用而受到越來越多的關注。然而,對于無鉛電介質陶瓷來說,可恢復儲能密度(Wrec>10 J/cm3)和效率(η>80%)的協同提高仍然是一個巨大的挑戰。
最近,南京理工大學和南京航空航天大學的研究人員通過在NaNbO3基體(NN-BNFT)中引入具有較小容限因子的復合鈣鈦礦化合物(Bi0.9Na0.1)(Fe0.8Ti0.2)O3,獲得了具有增強弛豫行為的穩定弛豫反鐵電陶瓷。對0.88NN-0.12BNFT組分,致密的微觀結構、中等的介電常數、減小的晶粒尺寸和介電損耗以及樣品厚度等因素,導致了87.3 kV/mm的大擊穿強度Eb、12.7 J/cm3的超高Wrec值和82.5%的高效率η,以及優異的熱可靠性和超快的放電速度。這種NN-BNFT電介質材料卓越的儲能性能使其在先進儲能介質電容器中顯示出巨大的應用前景。該研究成果以“Ultrahigh Energy Storage Density and High Efficiency in Lead-Free (Bi0.9Na0.1)(Fe0.8Ti0.2)O3-Modified NaNbO3 Ceramics via Stabilizing the Antiferroelectric Phase and Enhancing Relaxor Behavior”發表于ACS Appl. Mater. Interfaces上。
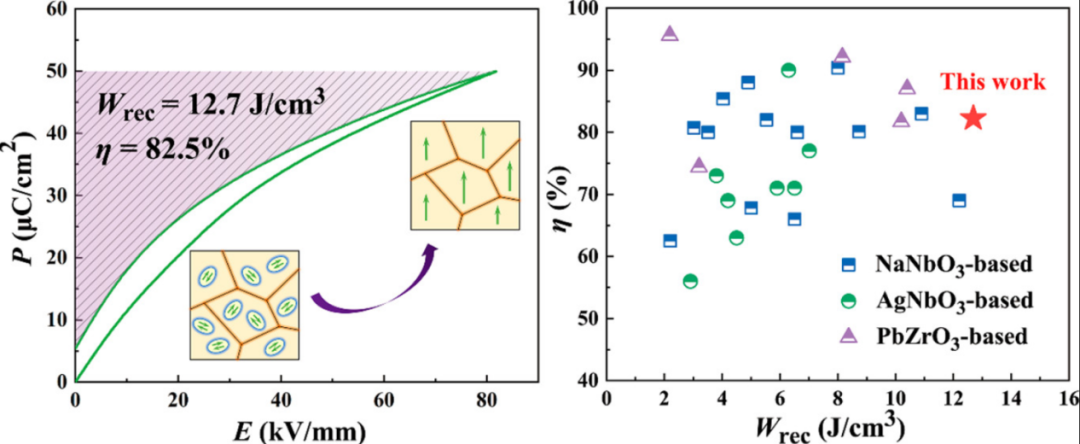
圖1. 通過穩定反鐵電相和增強弛豫行為實現無鉛(Bi0.9Na0.1)(Fe0.8Ti0.2)O3改性NaNbO3陶瓷的超高儲能密度和高效率
論文鏈接:https://doi.org/10.1021/acsami.2c02086
2、J. Mater. Chem. C:用于高溫電容儲能的CaCu3Ti4O12納米線/聚醚酰亞胺納米復合材料界面絕緣層特性的調節
大量研究證實,在高介電常數納米填料表面包覆絕緣殼層可以有效提高聚合物基電介質納米復合材料的儲能性能。然而,目前還缺少殼層絕緣性的變化如何影響介電性能方面的研究。
近日,華東理工大學的研究人員選擇了三種具有不同帶隙的無機氧化物,包括SiO2(SO)、HfO2(HO)和TiO2(TO),作為CaCu3Ti4O12納米線(CCTO NWs)的外殼層。通過將納米線添加到聚醚酰亞胺(polyetherimide,PEI)基體中,制備得到聚合物納米復合材料。絕緣殼層不僅可以抑制自由電荷遷移,還可以減輕納米復合材料中的電場畸變,從而顯著降低介電損耗,提高擊穿強度。殼層的帶隙越大,性能越突出。高絕緣殼層使納米復合材料能夠實現更高的放電能量密度(Ud)。在350 MV m-1的電場下,納米復合材料的Ud值(15 vol% HO@CCTO NWs/PEI)達到5.4 J cm-3,約為純PEI(1.9 J cm-3)的285%。此外,核殼結構的CCTO/PEI納米復合材料表現出更優異的介電熱穩定性,展現出作為高溫介電材料的潛力。該研究工作以“Tuning the Interfacial Insulating Shell Characteristics in CaCu3Ti4O12 Nanowires/Polyetherimide Nanocomposites for High-Temperature Capacitive Energy Storage”發表于J. Mater. Chem. C上。
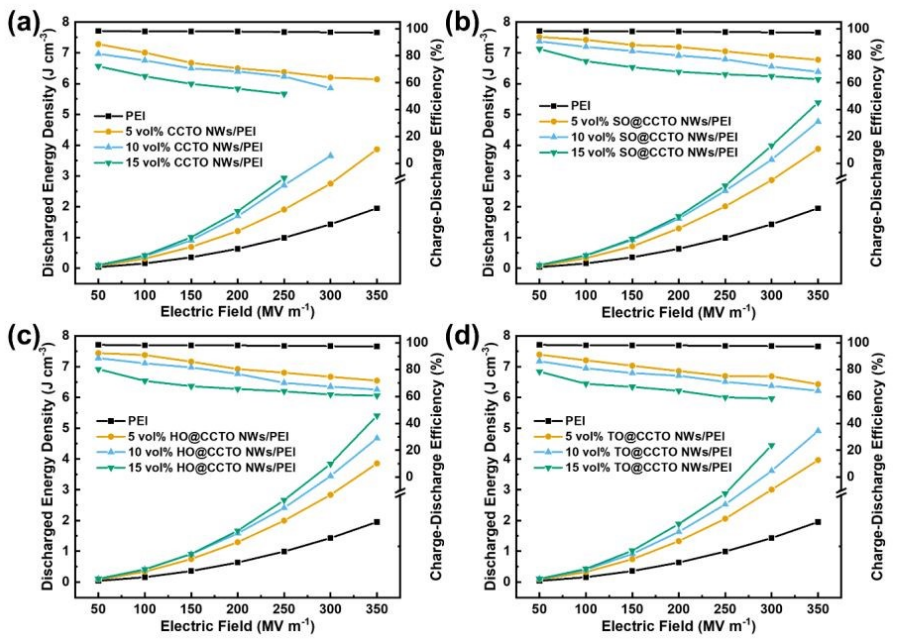
圖2. 放電能量密度和充放電效率
論文鏈接:https://doi.org/10.1039/D2TC00968D
2 熱管理材料
1、J. Mater. Chem. C:液態金屬橋接球形BN大幅提高熱界面材料的導熱性能和機械性能
隨著先進微電子設備的迅速發展,人們迫切需要具有高導熱系數和優異力學性能的熱界面材料。通常情況下,在聚合物中添加傳統的導熱填料會導致熱界面材料的力學性能變差。
最近,深圳大學和深圳先進電子材料國際創新研究院的研究人員采用液態金屬(liquid metal,LM)作為輔助填料填充球形氮化硼(spherical boron nitride,SBN)聚合物熱界面材料。由于液態金屬橋接了分布在“島”中的球形氮化硼,熱界面材料獲得了高導熱性(4.00 W m?1K?1,提高227.66%)和優良的力學性能(斷裂伸長率198.96%,提高81.24%)。結果表明,液態金屬作為一種柔性填料,不僅可以取代剛性填料,通過表面接觸降低填料之間的接觸熱阻,而且在一定程度上改善了力學性能,突破了傳統剛性填料的缺陷,為熱界面材料的未來發展提供了思路。這項研究工作以“Liquid bridge: liquid metal bridging spherical BN largely enhances the thermal conductivity and mechanical properties of thermal interface materials”發表于J. Mater. Chem. C上。深圳先進電子材料國際創新研究院熱管理材料研究中心在讀碩士研究生李俊鴻為第一作者,任琳琳副研究員為共同通訊作者。
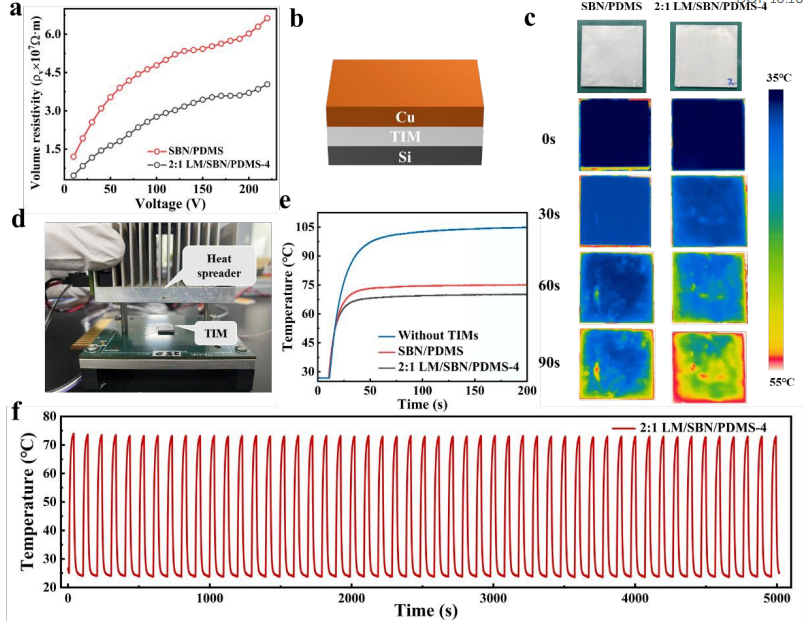
圖3. 開發的新型熱界面材料在芯片熱管理上的應用展示
論文鏈接:https://doi.org/10.1039/D2TC00099G
3 電磁屏蔽材料
1、Nano-Micro Lett.:評述文章——聚合物基電磁屏蔽復合材料的開發
航空航天武器裝備、無線基站和5G通信技術的飛速發展對聚合物基電磁干擾屏蔽復合材料的綜合性能提出了更新、更高的要求。然而,目前制備的大多數聚合物基電磁屏蔽復合材料仍然難以將高性能和多功能性結合起來。
最近,西北工業大學的研究人員發表評述文章,基于相關研究工作,提出了突破上述瓶頸的三個可能方向,包括構建高效的導電網絡、面向輕量化的多界面優化以及多功能兼容性設計,并展望了三個方向的未來發展趨勢。該觀點可為聚合物基電磁屏蔽復合材料的制備、研究和開發提供一定的理論依據和技術指導。該評述文章以“A Perspective for Developing Polymer-Based Electromagnetic Interference Shielding Composites”發表于Nano-Micro Lett.上。
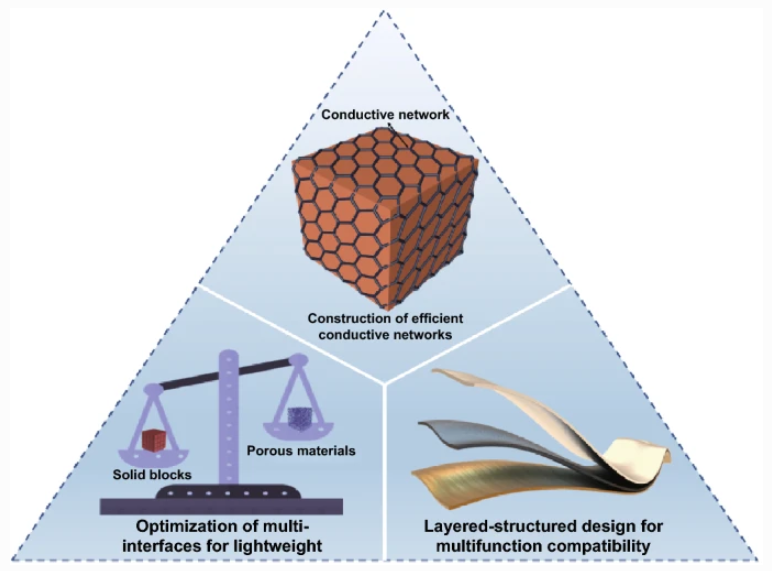
圖4. 聚合物基電磁屏蔽復合材料的開發
論文鏈接:https://link.springer.com/article/10.1007/s40820-022-00843-3
4 熱電材料
1、Matter: 熱電半導體PbTe中納米孿晶誘導的塑性機制
具有最低界面能的共格孿晶界(Coherent twin boundaries,CTB)提供了一個強大的聲子-CTB散射源,可抑制晶格熱導率(這是熱電性能所需的),但其對PbTe力學性能的影響尚不清楚。
近日,武漢理工大學等機構的研究人員沿(111)平面構建了以Pb或Te端接CTB(Pb-CTB或Te-CTB)的納米孿晶結構,并利用分子動力學模擬研究了結構演化。研究發現,Pb-CTB削弱了Pb-Te離子鍵,在CTB處產生了一個易位錯源。由于剪切載荷驅動下Pb-CTB平面上部分位錯的形核和運動,Pb-CTB逐漸遷移到Te-CTB,并伴隨著Pb-Te鍵的斷裂和重新形成。這種“捕捉鍵”保持了結構的完整性,同時顯著提高了納米PbTe的變形能力。位錯從Te-CTB向孿晶層移動,導致結構滑移和斷裂。這些發現為通過TB工程改善PbTe基半導體的延展性提供了理論策略。該研究工作以“Nanotwin-induced ductile mechanism in thermoelectric semiconductor PbTe”發表于Matter上。

圖5. 熱電半導體PbTe中納米孿晶誘導的塑性機制
論文鏈接:https://doi.org/10.1016/j.matt.2022.03.010
5 電子封裝材料
1、J. Electron. Pkg.:六方氮化硼/環氧樹脂和BNNS/環氧樹脂復合材料對倒裝芯片可靠性的影響
在電熱-機械耦合作用下,電子器件容易發生失效和性能退化,這已成為微電子封裝中一個重要的可靠性問題。
近期,中南大學的研究人員報道了利用熱界面材料提高倒裝芯片可靠性的方法。首先,建立了倒裝芯片封裝系統的三維有限元模型,并對電熱力多場耦合進行了有限元模擬。然后,分析了高電流密度下倒裝芯片的焦耳加熱、溫度分布、熱應力和變形。同時,研究了熱界面材料的導熱系數和工作電流對倒裝芯片可靠性的影響。結果表明,當熱界面材料的導熱系數從0.2?W/m·K增加至6?W/m·K時,倒裝芯片的最高溫度和最大等效應力降低了6.35?℃和14.6 MPa。研究團隊在高電流密度下對連接到散熱器上的倒裝芯片進行了可靠性實驗,得到了不同熱界面材料下倒裝芯片的溫度變化。通過結合實驗和仿真,分析了熱界面材料對倒裝芯片可靠性的影響。結果表明,當熱界面材料的導熱系數為0.2?W/m·K、3?W/m·K、6?W/m·K時,倒裝芯片系統的對應溫度為111.2℃?、105.0℃?、102.7℃?。使用所制備的高導熱性氮化硼納米片/環氧樹脂復合材料,電子設備的可靠性和使用壽命得到了有效提高。該研究工作以“Effect of Hexagonal-Boron Nitride/Epoxy and BNNS/Epoxy Composite Materials on the Reliability of Flip Chip”發表于J. Electron. Pkg.上。
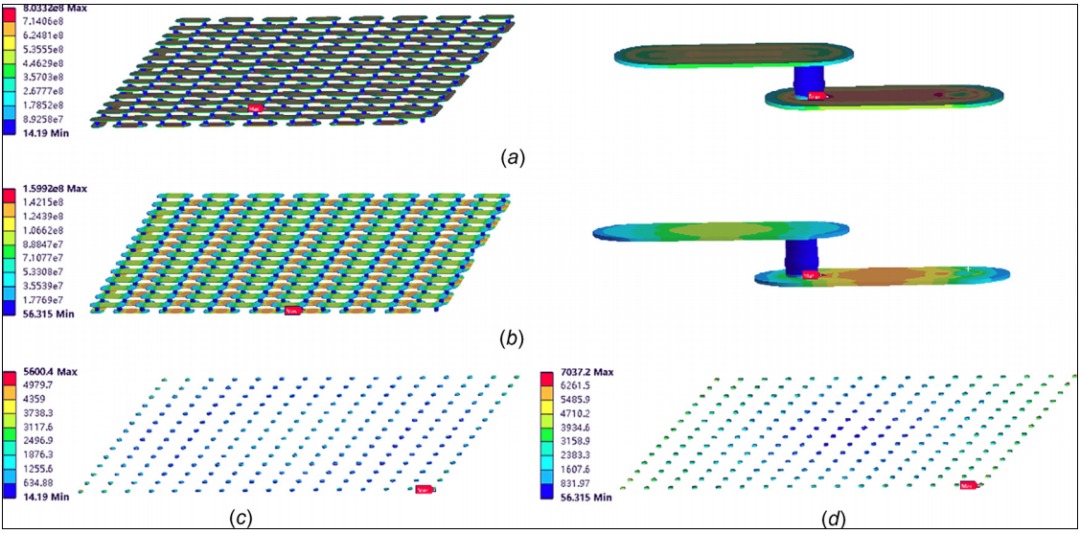
圖6. 倒裝芯片中的等效應力分布
論文鏈接:https://doi.org/10.1115/1.4051468
2、Polymer Deg. Stabil.:循環濕熱老化下環氧樹脂準靜態和動態拉伸行為的實驗研究
航空中使用的纖維增強聚合物(Fiber-reinforced polymer,FRP)結構通常暴露在循環濕熱環境中,在這種環境中,它們可能受到威脅飛行安全的沖擊載荷。盡管濕熱老化對FRP力學性能的影響已被廣泛探討,但很少有人討論復合材料在長期濕熱老化后的沖擊誘導行為,也幾乎沒有任何研究考察濕熱老化后純環氧樹脂應變率的影響。
近日,南京航空航天大學的研究人員首次考察了TDE86環氧樹脂在循環濕熱老化下的準靜態和動態拉伸性能。樹脂試樣老化0、1、7、14、28、56、70和140天,分別代表未老化、使用一個月、六個月、一年、兩年、四年、五年和十年的樣品。測試時的應變率范圍為7.5?×?10?6 s?1到1000 s?1,由此得出吸濕規律、裂紋誘導損傷的演化過程以及試樣的粘彈性行為,包括濕熱效應和環氧樹脂的應變率效應。這些信息可用于基于微觀力學方法預測FRP的濕熱行為。相關研究內容以“Experimental study of quasi-static and dynamic tensile behavior of epoxy resin under cyclic hygrothermal aging”發表于Polymer Deg. Stabil.上。
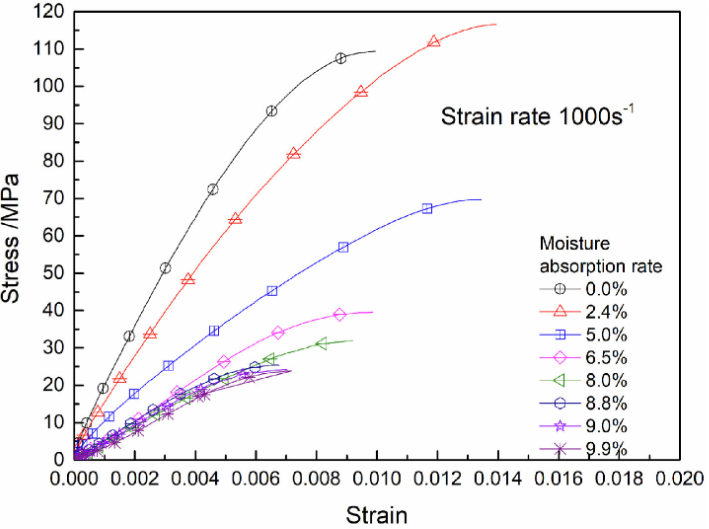
圖7. 不同吸濕率下平均應變率為1000 s-1時的應力-應變曲線
論文鏈接:https://doi.org/10.1016/j.polymdegradstab.2022.109940
3、IEEE Trans. Comp. Pkg. Man. Tech.:帶SAW濾波器的扇出型晶圓級封裝翹曲的實驗和數值研究
扇出型晶圓級封裝(Fan-Out wafer level package,FOWLP)技術是聲表面波(surface acoustic wave,SAW)濾波器封裝的理想方案,因為它有可能在晶圓的任何收縮模式(shrink pattern)下實現大量標準間距的互連。然而,在工藝過程中預測晶圓翹曲是一個棘手但有指導意義的問題。
近日,廈門大學的研究人員研究了不同封裝工藝中晶圓翹曲的演變,并改進了帶有SAW濾波器的FOWLP的翹曲控制方案。通過結合復合材料的細觀力學模型和橫向各向同性模型(transversely isotropic model),對固化變形進行了研究,同時考慮到LiTaO3的各向異性熱膨脹系數(CTE),開展了實驗和模擬分析,以揭示工藝、結構和材料效應對翹曲的影響。研究團隊還提出了一種新的實驗工藝,以減少亞毫米級芯片嚴重失配的影響。該方法得到的理論模擬結果與翹曲試驗結果一致,可將8英寸晶圓的翹曲度控制在2毫米以內。相關研究工作以“Experimental and Numerical Investigations of the Warpage of Fan-Out Wafer-Level Packaging with SAW Filters”發表于IEEE Trans. Comp. Pkg. Man. Tech.上。

圖8. 模擬(左)與測量(右)結果對比
論文鏈接:https://ieeexplore.ieee.org/document/9751102
文字 | 戰略研究辦
編輯 | 宣傳辦




